服务描述
目前我们为了能测试出晶圆表面这些超微量的金属离子当前大家使用的比较常见的技术手段一般为:VPD(Vapor Phase decomposition)化学气相分解)配合以下元素分析设备中的一种来实现:
1.TXRF(全反射X射线荧光光谱仪)
TXRF因为是X射线作为荧光的激发源,所以对于某些轻金属元素像Na、Mg、Al等超微量存在的离子无法检测出来,一般适用于重金属。
2.TOF-SIMS(时间飞行二次离子质谱)
TOF-SIMS能进行全元素检测,但是测试中标定定量太复杂。
3.ICPMS(电感耦合等离子体质谱)
ICP-MS几乎可分析几乎地球上所有元素(Li-U)该技术是80年代发展起来的新的分析测试技术。它以将ICP的高温(8000K)电离特性与四极杆质谱计的灵敏快速扫描的优点相结合而形成一种新型的强有力的元素分析、同位素分析和形态分析技术。该技术提供了极低的检出限、极宽的动态线性范围、谱线简单、干扰少、分析精密度高、分析速度快以及可提供同位素信息等分析特性。
因此以上3种方法中ICP-MS成为最优的选择。

测试过程(可实现全自动化)包括四个步骤:
1.将硅片置于 VPD 室中,并暴露于 HF 蒸气中以溶解自然氧化物或热氧化的 SiO2表面层
2.将提取液滴(通常为 250 μL 的 2% HF/2% H2O2)置于晶圆上,然后以精心控制的方式倾斜,使得液滴在晶圆表面上“扫掠”
3.随着提取液滴在晶圆表面上移动,它会收集溶解态 SiO2 与所有污染物金属
4.将提取液滴从晶圆表面上转移至 ICP-MS 或 ICP-MS/MS 系统中进行分析
除了以上操作过程中我们要避免在实验室二次污染我们操作过程中对环境及样品运输都有一个严格的标准,关于正确的运输包装我们建议您:

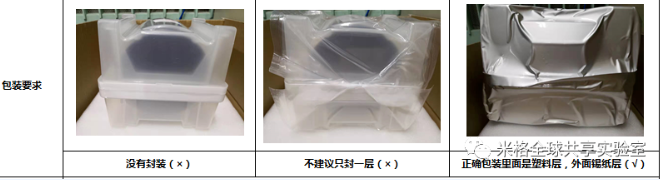
项目介绍
样品要求
样品大小:最大测试尺寸为12寸晶圆,测试样品一般不小于2寸
测试级别:E9级别或E10级别(标准测试)
结果展示

微信扫码直接开聊
关注我们



 绑定微信时刻了解进展
绑定微信时刻了解进展































